半導体(Semiconductor)とは
半導体とは、半導体集積回路の略称で、金属などの伝導体と、樹脂・ゴム等の絶縁体の中間的な抵抗率・電気伝導性を示す性質であって、本質は略されている「集積回路」の方にあり、トランジスタなどの半導体素子に利用されてます。




半導体は、PCやスマホ、テレビなどデジタル家電、冷蔵庫や洗濯機など白物家電、自動車などの用途、また、電気、ガス、水道、社会インフラまでの制御に至るまで、広範囲に使用され、人類の文化的生活に浸透しています。 特に、近年はモノのインターネット化が本格的に普及し、デジタルデータ量が飛躍的に増大し、途轍もない大量の半導体需要により、世界の半導体市場が拡大されてます。





2020年頃からの世界情勢により、ニュースでの報道もございますが、材料不足に伴い半導体製造が間に合わず、自動車の納車が半年先や1年先なども発生している様です。



半導体(集積回路ICチップ)の材料とは/(シリコン)
半導体とは、電気伝導性の良い金属などの良導体と、ゴムなどの絶縁体の中間的な抵抗率を持つ性質ですが、どんな材料から作られているのでしょうか。
地球上に存在する92種類の元素のうち、半導体として働けるものはシリコン、ゲルマニウム、セレン、カーボン(炭素)等、数種類のみです。



近半世紀は、地球上の約50%を占める酸素(O)の次に多く存在するケイ素(珪素、硅素)英称シリコン(元素記号Si)が材料として使う物量的な安定性と加工のし易さで多く使われます。
しかし、自然界では単体でなく、酸素と結びついて”ケイ石”として存在し、シリコン元素抽出には精錬が必要で、なかでも半導体に使われるシリコンはイレブン・ナイン99.9999999999%」という『超高純度の単結晶構造』が求められ、抽出後に精製されます。




なお、シリコンの精錬には大量の電力が必要な為、日本では電力の比較的安価なオーストラリアや中国、ブラジル等から精錬された純度98%以上の金属シリコン(インゴット)として輸入してます。インゴットとは、円柱状の高純度のケイ素-シリコンの塊のことで、厚さ1mm程度の厚みで円板状にスライスされたものがシリコンウェハと呼ばれる半導体の基材となります。


シリコンバレーSilicon Valleyには世界最大のハイテク企業が存在し、米国のベンチャーキャピタル投資の3分の1を占めるといわれ、この地域で、シリコン集積回路、マイクロプロセッサ、マイクロコンピュータなどの技術が開発され、半導体やソフトウェアの発展が経済の主要な要素だそうです。
半導体ウェハーSemiconductors Waferとは
シリコンウェハーSilicon Waferとは
半導体素子用として、シリコンなどの元素から成る円柱素材から、厚さ1mm程度にスライスして円盤状に切り出した板材を半導体ウェハー、シリコン製はシリコンウェハーと呼称されます。
英語原音ではウェファに近いのですが、薄い洋菓子のウエハースが語源となっており、カナ表記では、ウェハ、ウェハー、ウェーハと混在してます。




用途上、特に表、面片面は機械的に化学的に繰返し研磨され、極めて平滑な鏡面状態になります。
厳密には円形でなく、製造の位置決め用に、ノッチ切欠きと、フラット直線部位が有ります。



大きさは、呼称外径寸法φ2inch~φ12inch(50~300mm)、厚さは径寸法毎に業界団体等で0.5mm~1mmと標準化されてます。
外径が大きいほど一枚のウェハーから多数のチップを生産出来、効率的・経済的だが、材料や加工の技術的な難易度が高く、2000年頃普及した8~12inchまでが主流です。
半導体の製造工程とは
半導体は、シリコンウェハー表面上にトランジスタなどを含む電子回路、ICチップの様な微細なプログラム回路を形成する前工程、ウェハーから半導体を切り出し、組立・検査を行う後工程、長い製造工程を経て製造されてます。



一枚のウェハーには同じパターン回路が格子状に縦横に規則正しく並んだ状態で焼付けられます。後工程と呼ばれる工程で、格子状の境界に沿って切り出していくこと(ダイシング)により、矩形の半導体チップ単体(ダイ)が作られ取出されます。
半導体製造工程 ダイシングDicingとは
半導体は、前工程・後工程と、長い工程を経て製造されます。
前工程で、1枚のウェハーに同じパターン回路が格子状に縦横に規則正しく並んだ状態で焼付け、後工程で、格子状の境界で切出し、半導体チップ単体(ダイ)が作られパッケージングされます。
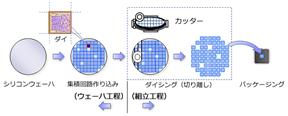
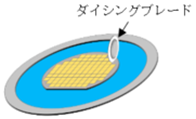

ダイシング(英称DicingまたはDie Cutting)とは、後工程でウェハー上に複数形成された半導体素子(ダイDie)を切出分割カットする工程のことです。
加工は、ダイヤモンド製の極薄の円形回転刃ダイシングブレードを高速回転させて、切削箇所に純水を噴射し、摩擦熱の冷却と切削屑を除去しながら切出すダイサー方式が多いです。
ウェハー上に形成される素子チップ間に設ける切りしろスペースは概ね100μm(0.1mm)以下で、無駄無く使用出来ることが歩留に直結するので高精度が要求される工程です。
ダイシングテープとは
ダイシングテープとは、半導体製造後工程用いる特殊用途の樹脂フィルム製テープです。


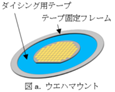
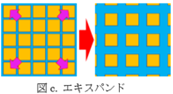
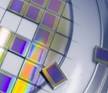
ダイシング切出し加工時に素子チップが飛散しない様に、フレームにセットしたダイシングテープ粘着糊面にウェハーが貼付け固定されます。
加工後は、紫外線UV照射でテープ糊剤を硬化させて粘着力を低下させたり、テープを引延しエキスパンドしてチップ同士の距離を確保し、カットして素子を取出し易くします。
半導体分野においても、ダイシングテープ、UV保護フィルム、マスキングテープなど、樹脂製のフィルムが採用されています。
